當高的dv/dt供給漏極時,在功率MOSFET中有一個電流傳導的可能性,在一些情況下,這可以損毀器件。下面給出一些由于dv/dt器件導通的實例。
(1)靜態dv/dt
1. 假導通
2. 寄生晶體管導通
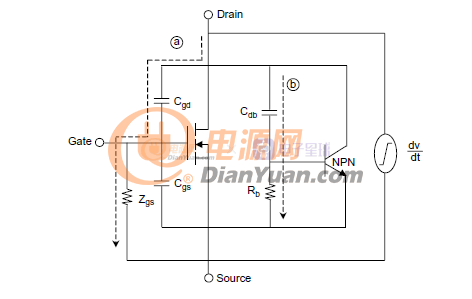
1. 在關斷狀態,漏極電壓的突然增加改變整個漏極和柵極之間的寄生電容,產生位移電流(a)C*dv/dt。如果由于位移電流和柵-源阻抗(Zgs)在柵極和源極之間形成的電壓超過Vgs(th),它觸發一個假的MOSFET關斷。這里,漏極和柵極之間的寄生電容根據電路布線可以等于Cgd或比Cgd大。Zgs是驅動電路的阻抗,可以表示為R、L串聯的電路。由于假導通,器件進入一個電流導通狀態,在嚴重的情況下,在器件內形成高的功率耗散且造成毀壞性的失效。下列等式展示Zgs與Vgs間的關系,和在這個模式下dv/dt的性能。
Vgs = ZgsCgd(dv/dt)
(dv/dt) = Vgs(th)/(ZgsCgd)
為了增加dv/dt的性能,應該使用一個低阻抗的柵極驅動電路,且Vgs(th)必須增大。但在一個低阻抗驅動電路中,成本較高且Vgs(th)的增大與Rds(on)的增大有關。當Vgs(th)具有負的溫度系數,假導通的可能性隨著溫度上升而增大。但通常來說,柵極電壓不會超過門限電壓,高的器件電阻會限制器件電流。因此,由于假導通導致的器件毀壞是罕見的。
2. 在關斷狀態,一個突然增加的漏極電壓改變整個Cdb的電壓,而且它形成流過Rb的電流(b)。當Rb的電壓超過Vbe(寄生雙極性晶體管導通時的射級-基極正向偏置電壓,大約為0.7V)時,寄生雙極性晶體管導通。當寄生雙極性晶體管導通,器件的擊穿電壓從BVcbo減小到BVceo,它是BVcbo的50%~60%。如果供給一個比BVceo大的漏極電壓,器件陷入雪崩擊穿。如果這個樓及電流沒有外部限制,器件會被二次擊穿損壞。下列等式表示在這個模式下dv/dt的性能。 (dv/dt) = Vbe/(RbCdb)從上述等式可以很容易發現dv/dt的性能由器件內部結構決定。對于高dv/dt性能,Rb值必須要小。這個可以通過增加P-body區域的參雜水平和盡量減小N+發射極的長度實現。Rb也會被漏極電壓影響,當漏極電壓增加,耗盡層擴大且加大Rb值。當溫度增加時,流動性減小而Rb增加和Vbe減小,寄生晶體管導通的可能性增大。但當基極和發射極通過源極接觸而短接時,Rb值很小。這個只在dv/dt異常大時才會發生。→在假導通時dv/dt可以被外部控制,但在寄生晶體管導通時,dv/dt是由器件的設計決定的。這是這兩個模式的區別。
(2)動態dv/dt如果有一個突然的電流中斷,例如在高速開關中的鉗位電感關斷,器件會被并發的應力損壞,這是由寄生電容的高漏極電流、高漏源電壓和位移電流造成的。
(3)二極管恢復dv/dt這是在特殊應用中dv/dt失效的主要原因,例如電路使用一個體漏二極管。數據收集給出了dv/dt的最大值。超過這個值將會造成由于二極管的過度恢復dv/dt的器件失效。下圖展示了一個電機控制電路應用,該應用有二極管恢復dv/dt的問題。
首先Q1和Q4導通,且進入一個電流i1通過的狀態。如果Q1關斷來控制電機速度則電流i2會流經Q3的寄生二極管(續流二極管)。Q3的寄生二極管進入正向偏置狀態,同時由于二極管的特性,少數電荷開始累積。當Q1通道,電流再次變回i1,在Q3的寄生二極管中積累的少數電荷被二極管反向恢復電流移除(如圖20a部分)。一旦少數電荷被移除到一個特定水平,體漏二極管的耗盡區擴大且產生更多的反向恢復電流(如圖20b部分)。如果這打開了寄生雙極性晶體管,則Q3會被損壞。圖20展示二極管恢復dv/dt測試電路和波形圖。從這個測試,不僅僅可以獲得dv/dt,而且可以獲得Vsd(二極管正向電壓)、trr(反向恢復時間)和Qrr(反向恢復電荷)的數據。測試里,Vdd值必須小于等于BVdss。通常Vdd設定為BVdss的80%,而且驅動器的Vgs脈沖周期必須控制以使Is可以變為連續的漏電流Id。

當Rg減小,di/dt和dv/dt值變大。首先,trr可以通過測量圖示中Is部分獲得,這里di/dt(從地電勢上的50%Ifm的點到地電勢下75%Irm的點之間測量)是100[A/us]。Qrr可以用(Irm*trr)/2計算。dv/dt可以從數據手冊中在di/dt條件下Vdd的10%~90%之間的點測量。Is(連續源極電流)和Ism(脈沖源極電流)表示源-漏二極管的額定電流,Is = Id(連續漏極電流),Ism = Idm(漏極脈沖電流)。